QFN的加工方法
解決方案
隨著半導體封裝元件的小型化/多品種化製程的不斷發展,QFN(Quad Flat Non-leaded Package)的切割方法也發生了改變,從原來使用剪床和銑床改為使用切割機進行切割加工。能否有效地抑制銅材料特有毛邊的發生,並儘可能地提高生產率已經成為加工QFN時的關鍵因素。在這裡將向大家介紹可對QFN實施高品質加工(減少毛邊的發生及提高生產率)的新型樹脂結合劑切割刀片和適用於加工QFN的切割機
切割刀片
-
使用電鑄切割刀片進行加工
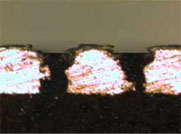
-
使用新型樹脂結合劑切割刀片進行加工
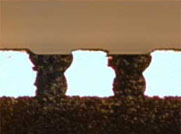
QFN基板 全金屬設計(提供廠商: 大日本印刷株式會社)
原來在對QFN等半導體封裝元件進行切割加工時,通常使用的是電鑄切割刀片。但是,由於該類型切割刀片在半徑方向上的消耗量比側面少,導致其側面形狀相對單薄,從而引起晶粒形狀變形以及使用壽命縮短等問題的發生。
在這裡介紹的新型樹脂結合劑切割刀片由於具有垂直消耗的特點,因此能有效地降低晶粒變形現象的發生。該新型切割刀片不但能在使用壽命結束之前保持晶粒的形狀不變並有效地抑制銅製電極部位毛邊的發生,而且與原來的樹脂結合劑切割刀片相比,不僅具有優異的耐磨性,還有可能提高生產率。
有關新型樹脂結合劑切割刀片的詳細內容,請咨詢本公司銷售負責人。
設備
迪思科公司的切割機系列產品在高精度加工及操作便利性方面不斷地追求創新,已經獲得了世界各地客戶的信賴和支持。經過向客戶提供豐富的機種,不斷滿足市場對半導體封裝元件切割(Package Singulation)的需求。
治具切割(Jig Singulation) (使用治具固定加工物)
迪思科公司的CSP用切割機,利用與搬運設備製造廠家的自動搬運機組合使用,就能夠完成從分割半導體封裝元件到裝入晶片盒為止的同一系統化作業,全部實現自動化操作。
- 降低運行費用
- 適合少品種基板的大批量生產

膠膜切割(Tape Singulation) (使用膠膜固定加工物)
膠膜固定方式可適用於所有類型的切割機
- 只要改變設備的設定數據,就能夠對應不同的半導體器件
- 能夠加工小型晶粒
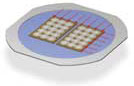
無論是治具固定方式還是膠膜固定方式,都能使用加工物的測長校準功能克服半導體封裝元件的收縮現象,並可作多個加工物同時粘貼生產。
相關情報
適用於分割半導體封裝元件基板的產品
https://www.disco.co.jp/cn_t/products/index.html?id=package

