应对多样化的封装研磨需求
全自动研磨机「DFG8020」「DFG8030」
两机种同时市场展开
半导体制造设备制造商・株式会社迪思科(总部:东京都大田区,社长:关家一马)开发出了支持多样化封装研磨需求的两机种全自动研磨设备。同时展开最大390×390 mm尺寸的面板级封装对应的「DFG8020」,和条形(短条形基板)对应的「DFG8030」。两机种于2020年12月14日~17日在SEMICON Japan Virtual展出。


开发背景
5G服务开始,以智能手机为首的高端移动终端的零部件数量增加。与此同时,高频(RF)模块和功率管理模块等采用FOWLP※1和PLP※2等高密度实装,提高了以封装的低背脊化和布线层形成等为目的的磨削需求。
而且,在WLP※3或PLP等的制造工艺中,树脂密封时的形状有圆形和长方形等多种多样,包括现有的短条形・条形基板,寻求在磨削设备方面的灵活应对。
为了满足这些需求,开发了最大支持390×390 mm尺寸的封装磨削的「DFG8020」和实现条状高吞吐量加工的研磨设备「DFG8030」。
※1 Fan Out Wafer Level Package:通过在晶片上排列分离的芯片,将从芯片端子引出配线的再布线层形成在芯片外侧,实现多脚化等的封装方法
※2 Panel Level Package:将多个半导体芯片排列在角形面板上进行封装的方法
※3 Wafer Level Package:以在晶片上排列了分离前的晶片的状态或芯片的状态一次性封装的方法
产品特点
DFG8020/DFG8030共通
- 从工件的装载到加工,清洗,收纳到晶圆框架盒中,全自动实施
-
2主轴・2工作台构造
工作流程示例
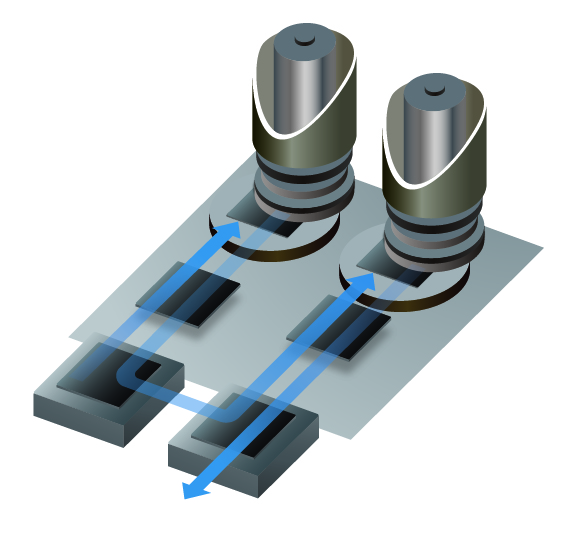
2轴加工(粗研磨→精研磨等) 
单轴・并联加工 -
加工点优化后的高平坦度研磨
- 通过设想使用大口径Φ500 mm磨轮的设计,确保加工轴的刚性和稳定性
- 抑制工作面内平坦度的不规则性
-
可以切换研磨方式
- 通过工作盘和磨轮的旋转进行进料研磨
- 将工件送入旋转磨轮的Creep feed研磨
DFG8020
面板尺寸对应的全自动研磨机
- 最大支持390×390 mm工件,Φ300mm 用Tape frame※4
-
尺寸・重量
W1,660 × D4,400 × H1,800 mm,約5,700 kg
DFG8030
具有带状用传送机构的全自动研磨设备
- 支持宽45~100 mm,长度100~300 mm的条形及小口径晶圆※5
-
对应多个工件的同时研磨的高吞吐量加工

加工台的配置图 - 通过加工过程中的非接触厚度测量※5随时控制适当的研磨量
-
尺寸・重量
加工部:W1,660 × D2,300 × H1,800 mm
搬送部:W2,500 × D1,500 × H1,800 mm
重量:約5,950 kg(加工部・搬送部合计)
※4:特殊対応
※5:选项
今后的计划
| SEMICON Japan Virtual 2020出展 | 2020年12月14日~17日(至2021年1月15日阅览可) |
|---|---|
| 试做/test cut | 正在受理 |
| 预计开始销售 | 2021年 9月 |
关于株式会社迪思科
为一家提供用于半导体・电子零件制造的切割机和研磨机等的精密加工设备,以及安装在设备上使用的精密加工工具的半导体制造设备商。加之追求设备和工具的使用技术,持续提供最合适的加工结果,在国内外的器件制造商以及半导体委托制造企业中广泛采用了本公司的产品和加工技术。详细情况请阅览网站www.disco.co.jp。
