高频率电子元件中所使用的GaAs(砷化镓)等化合物半导体,在采用金刚石磨轮刀片进行切割(以下:磨轮刀片切割)时,进给速度慢,难以提高生产效率。
另外,在SiP(System in Package)等高集成化的背景下,高抗折强度的薄片制造技术也越来越重要。然而,对于磨轮刀片切割来说,晶片的厚度越薄,切割的难度也就越大。
为了解决这些问题,迪斯科致力于优化激光切割机DFL7161的激光头和光学系统,确立了激光全切割应用技术。
应用技术
激光全切割工艺
本工艺是在厚度200 µm以下的薄型晶片表面(图案面),用激光照射1次或多次,切入胶带实现晶片全切割的切割方法。因为激光全切割可以加快进给速度,从而可以提高生产效率。

加工实例
GaAs化合物半导体的薄型晶片切割
GaAs晶片因为材料比较脆,在切割时容易发生破裂或缺损,所以难以提高通常磨轮刀片切割的进给速度。如果利用激光全切割技术,加工进给速度可以达到磨轮刀片切割进给速度的10倍以上,从而提高生产效率。(进给速度仅为一例。实际操作时,因加工晶片的不同会有所差异。)
采用激光全切割工艺,加工后的切割槽宽度小,与刀片相比切割槽损失少,所以可以减小芯片间的间隔。对于为了切割出更多小型芯片而致使加工线条数增多的化合物半导体晶片而言,通过减小芯片间的间隔,可以提高1枚晶片中可生产的芯片数量。
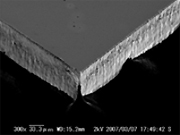
※GaAs加工时,去除气化As气体的附属设备必不可少。
薄型化硅晶片的全切割加工
随着晶片的薄型化,切割时的崩裂和裂缝对芯片强度的影响也越来越大,切割的难度也越来越大。因此,需要有可以进一步抑制崩裂现象的加工方法。另外,随着薄型化芯片积层接合材料DAF(Die Attach Film)使用的增加,如何对背面粘贴DAF的晶片进行抑制毛边等现象发生的高质量切割,也成为一个重要的课题。
针对这些课题,迪思科确立了作为薄型硅晶片切割的解决方案之一的激光全切割应用技术。激光全切割,通过激光的高速加工,使UPH得以提高。另外,对于附有DAF的硅晶片,可以进行硅和DAF的一体切割或单独切割。
-
硅晶片
芯片表面照片
-
附DAF的硅晶片
芯片侧面照片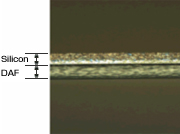
其他激光全切割加工实例
背面附金属膜的硅晶片、GaP(磷化镓)晶片、InP(磷化铟)晶片、GaN(氮化镓)晶片、Ge(锗)晶片等。
对应机种
本产品是,对适用于Φ300 mm晶片并在Low-k膜开槽加工中获得广泛好评的全自动激光切割机DFL7161的激光头和光学系统进行了优化之后,而用于激光全切割的设备。



