最大400mm角のパッケージ切断に対応したダイシングソー「DFD6080」を開発
半導体製造装置メーカー・株式会社ディスコ(本社:東京都大田区、社長:関家一馬)は、最大400mm角のワークサイズに対応したフルオートダイシングソー「DFD6080」を開発しました。
なお、本装置はSEMICON Japan 2025(12/17-19 東京ビッグサイト)に出展する予定です。
開発背景
AIの普及やDXの推進などにより半導体製品の需要は拡大傾向が続いています。生産性向上のため、Φ300mmのウェーハをキャリアにパッケージ製造するFOWLP(Fan out wafer level package)が普及しており、更に生産効率を高めるため、大型基板を用いたパッケージングPLP(Panel Level Package)」の開発が進んでいます。
当社では、720×610mmの大判に対応したPLP向けダイシングソー「DFD6310」を2016年にリリースしており、この度さらに幅広い加工需要に応えるため、400mm角ワークまで対応可能な「DFD6080」を開発いたしました。

特徴
- 400mm角までのパッケージ切断に対応
-
多枚貼りで加工を効率化
複数のストリップ基板を1枚のフレームに貼り付けて 個片化することで、生産性向上とコスト削減を実現
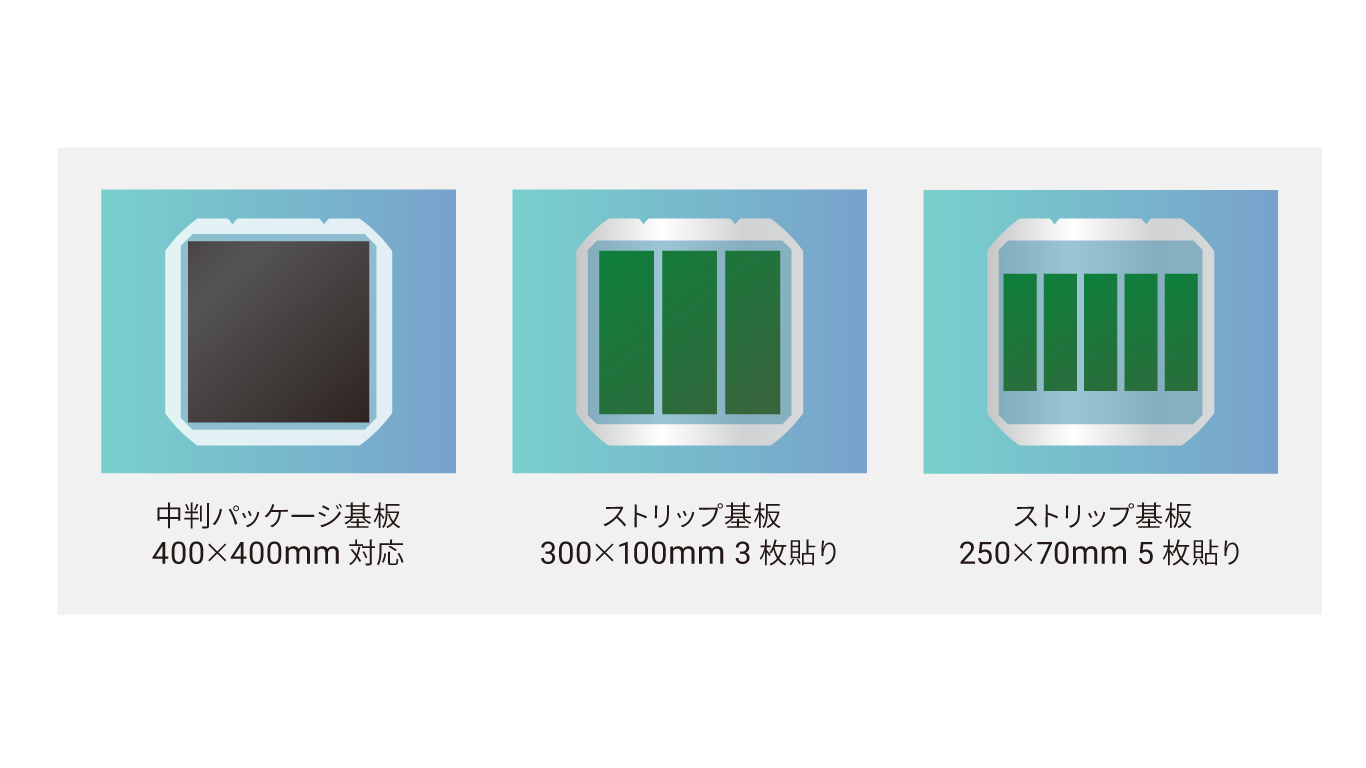
-
樹脂基板、ガラス基板、リードフレームなど幅広い素材・複合素材の切断に対応
- 1.8kWの高出力スピンドル(標準搭載)
- 加工中のドレッシングが可能なサブチャックテーブル(標準搭載)
-
大容量のABC(オートブレードチェンジャー)を搭載(オプション)
- ワンタッチでブレードの供給・回収が可能な「ブレードストッカ」を採用
- ハブブレード:80枚以上 ハブレスブレード:200枚以上 をストック可能
今後の対応
| SEMICON Japan 2025出展 | 2025年12月17日~19日 東京ビッグサイト |
|---|---|
| テストカット | 受付中 |
| 販売開始予定 | 2026年下期 |
株式会社ディスコについて
当社は、半導体や電子部品の製造に使用されるダイシングソーやグラインダなどの精密加工装置、および装置に取り付けて使用する精密加工ツールを提供する「半導体製造装置メーカー」です。これら製品に加え、装置とツールの利用技術の提供によりお客様の最適な加工結果を追求してきた結果、国内外のデバイスメーカーおよび半導体受託製造企業などに広く、当社製品・加工技術が採用されています。
詳細については、ウェブサイトwww.disco.co.jpをご覧ください。
お問い合わせ
株式会社ディスコ 広報室
