DBG(Dicing Before Grinding)프로세스
솔루션
DBG프로세스란?
DBG는 이전의 다이싱(Dicing)이라는 프로세스를 정반대로 바꿔, 먼저 웨이퍼를 하프 컷(Half cut)한 후에 백그라인딩(Back Grinding)을 실시하여 칩을 분할하는 기술로, 칩 분할(Dicing)시의 이면 칩핑과
웨이퍼 파손을 최소화하면서 대구경의 웨이퍼에서 칩을 분리할 수 있습니다.
이면 칩핑이 적어, 높은 항절강도를 유지하면서 초박형 웨이퍼(Ultra Thin Wafer)가공이 가능하여 강도가 높은 칩을 생산할 수 있습니다.
또한, 그라인더에 의한 연삭으로 칩 분할이 가능하며 박형 웨이퍼(Thin Wafer)를 반송하는 리스크가 없어지는 장점이 있습니다.
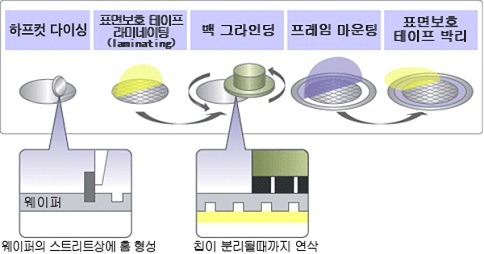
하프컷 다이서(Dicer)로 웨이퍼상의 스트리트(절단면)에 홈 형성을 합니다. 일반적으로 다이싱에서는 풀 컷(Full cut)을 하지만, DBG프로세스의 경우에는 완성품의 칩 두께까지 하프컷을
실시합니다.
하프컷 다이싱 후에 웨이퍼 표면에 보호 테이프를 부착하여 백그라인딩(Back Grinding)을 실시합니다. 연삭이 진행되어, 하프컷한 홈에 도달했을 때에 웨이퍼는 각각의 칩으로 분리됩니다(칩 분할). 이 분할된
웨이퍼는 인라인(In-Line)으로 DBG마운터로 반송하여 얼라이먼트 후, 프레임 마운트를 합니다. 프레임 마운트 후에 표면보호 테이프를 떼어내고 공정은 종료됩니다.
관련정보
DBG대응제품 상세
https://www.disco.co.jp/kr/products/index.html?id=dbg
문의
질문・상담이 있으시면 언제든 문의해 주십시오.

