SDBG (Stealth Dicing Before Grinding)프로세스
솔루션
스마트폰이나 타블렛 PC가 점점 얇아지고 용량이 커지고 있는 가운데, 플래쉬 메모리나 메모리 컨트롤러 칩도 초박형화가 이루어지고 있는 추세입니다. 이러한 추세에 대하여 기존의 프로세스에서는 박형 웨이퍼(Thin Wafer)의 핸들링이나 다이싱에 의한 칩핑을 줄여나가야 하는 문제점이 있었습니다.
SDBG프로세스는 이러한 과제를 해결 함과 동시에,
- 칩 수율의 증가
- 박형 칩(Thin Die)의 항절강도 향상
SDBG 프로세스란
SDBG란 스텔스 다이싱 후 이면을 연삭하는 기술로, 박형 칩(Thin Die)의 스트리트를 협소화함과 동시에 높은 항절강도를 실현해냅니다.
다이 세퍼레이터(DDS Series)와 함께 사용하면, 박형 칩(Thin Die)을 적층하는 본딩재로 사용되는 DAF(Die Attach Film)를 고품질로 분할할 수 있습니다.
프로세스 공정
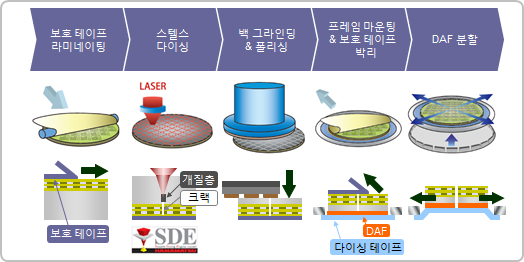
칩 취득개수 UP
스텔스 다이싱은 커프가 거의 0이기 때문에, 스트리트의 간격을 크게 줄일 수 있습니다. 기존의 다이싱과 비교하여, 한 장의 웨이퍼에서 얻을 수 있는 칩의 개수가 크게 증가합니다.
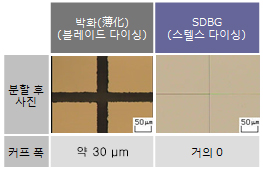

칩 항절강도 향상
블레이드에 의한 분할로 인한 표면・이면 칩핑 및 칩 측면에 남는 가공흔은 항절강도에 영향을 미칩니다. SDBG는 스텔스 다이싱에 의하여 개질층이 형성된 곳을 기점으로 칩을 분할하고, 개질 부분을 연삭으로 제거합니다. 따라서 표면・이면 칩핑을 줄이고 칩 측면의 가공흔이 남지 않는 고강도의 박형 칩(Thin Die)를 만들 수 있습니다.

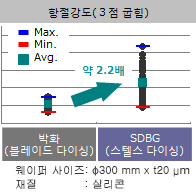
DAF(Die Attach Film)의 고품질 분할
다이 세퍼레이터(DDS Series)로 DAF를 저온 환경에서 확장(Expand)하여 고품질의 분할이 가능합니다.
다이싱 테이프의 늘어난 부분은 열 수축으로 해결되기 때문에 다이싱 테이프를 다시 붙일 필요 없이 바로 다이 본딩 공정으로 이어집니다.
관련정보
SDBG대응제품 상세
https://www.disco.co.jp/kr/products/index.html?id=sdbg
문의
질문・상담이 있으시면 언제든 문의해 주십시오.

